單片機產業發展芯方向—3D芯片封裝,單片機開發方案公司英銳恩分享芯資訊。集成電路業者開始探討后摩爾定律時代下集成電路的發展芯方向,而3D芯片封裝則是其中一個選擇。包括英特爾、臺積電、三星和一些OSAT廠都投入到3D芯片封裝的研發當中去。
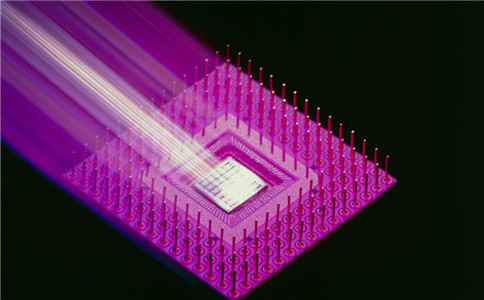
單片機芯片產業先進芯片封裝技術正處于百家爭鳴的時代,各單片機芯片廠商的先進芯片封裝技術有著各自的特點。但是隨著技術走向成熟、整合,芯片封裝技術會逐步實現統一。
3D芯片封裝號稱是超越摩爾定律瓶頸的最大“殺手锏”,又稱立體芯片封裝技術,是在X-Y平臺的二維芯片封裝的基礎上向z方向發展的高密度芯片封裝技術。
與傳統芯片封裝相比,使用3D技術可縮短尺寸、減輕重量達40-50倍;在速度方面,3D技術節約的功率可使3D元件以每秒更快的轉換速度運轉而不增加能耗,寄生性電容和電感得以降低,同時,3D芯片封裝也能更有效地利用硅片的有效區域。這種芯片封裝在集成度、性能、功耗等方面更具優勢,同時設計自由度更高,開發時間更短,是各芯片封裝技術中最具發展前景的一種。
外賣出現之前,我們永遠不知道泡面的競爭對手竟然不是同行。同樣,這也適用于封測行業,臺積電在摩爾定律發展的過程中,認識到后段芯片封裝技術與前段制程發展不一致的問題,公司認為此時此刻不如自己打通任督二脈,利用自家在前段制程的研發經驗來推動相關后段芯片封裝的發展。于是,臺積電推出了WLSI平臺,該平臺包括:CoWoS芯片封裝、InFO芯片封裝,以及針對PM-IC等較低端芯片的扇入型晶圓級芯片封裝。
國內應繼續加強在3D芯片封裝技術方面的投入,研發重點向新興技術轉移,同時提高專利申請質量。
以上是單片機開發方案公司英銳恩分享的3D芯片封裝芯資訊。